|
Где можно посмотреть информацию о физических ограничениях на значения характеристик компьютеров |
Применения УНТ и фуллеренов в информатике
Устройства памяти на основе УНТ
УНТ флеш-память с плавающим затвором
С использованием УНТ, как оказалось, можно построить много разных вариантов памяти. Начнем из аналогов современной флеш-памяти, описанной в лекции 6 курса "Наноэлектронная элементная база информатики на основе полупроводников и ферромагнетиков". Устройство ее типичной ячейки показано на рис. 6.11 слева. Основой ее является МДП транзистор с плавающим затвором, сформированный на пластине кремния 1; 2 – его исток, 3 – сток, 4 – "плавающий" затвор, 5 – изолятор, 6 – управляющий затвор.

Рис. 6.11. Слева – конструкция элементарной ячейки современной флеш-памяти; справа – конструкция элементарной ячейки флеш-памяти на УНТ и кантилевере (объяснения в тексте)
Справа на
рис.
6.11 показана конструкция ячейки флеш-памяти на УНТ транзисторе и кантилевере. Основой ее тоже является полевой транзистор с истоком 2, стоком 3, полупроводниковой УНТ 7 и "плавающим" затвором 4. Электрический заряд на этот затвор подается через управляющий электрод 6 и металлический кантилевер 9 (сформированный, например, из  ). В нормальном состоянии кантилевер 9 не имеет электрического контакта с плавающим затвором 4. Но в промежуток времени, когда на управляющий электрод 8 подается положительное напряжение, кантилевер 9 под действием электростатических сил прогибается и контактирует с затвором 4. На последний "перетекает" при этом необходимый электрический заряд. Когда импульс напряжения на электроде 8 исчезает, кантилевер 9 размыкается, и электрический заряд на изолированном затворе 4 может сохраняться очень долго, в т.ч. и при отключенном напряжении питания.
). В нормальном состоянии кантилевер 9 не имеет электрического контакта с плавающим затвором 4. Но в промежуток времени, когда на управляющий электрод 8 подается положительное напряжение, кантилевер 9 под действием электростатических сил прогибается и контактирует с затвором 4. На последний "перетекает" при этом необходимый электрический заряд. Когда импульс напряжения на электроде 8 исчезает, кантилевер 9 размыкается, и электрический заряд на изолированном затворе 4 может сохраняться очень долго, в т.ч. и при отключенном напряжении питания.
Вместо кантилевера для выполнения той же функции может быть использовано и описанное выше наноэлектромеханическое реле на УНТ, изображенное на рис. 6.10.
Можно указать следующие преимущества описанной ячейки памяти по сравнению с обычной флеш-памятью. Для записи и стирания информации не нужно доводить изолирующий слой до состояния контролируемого электрического пробоя. Поэтому этот слой не повреждается, и число циклов записи/перезаписи информации возрастает на порядки величины. Занесение и стекание электрического заряда с плавающего затвора происходит через металлический кантилевер, и поэтому запись/перезапись информации значительно ускоряются. Заряд, перетекающий на плавающий затвор, можно значительно точнее контролировать. А это позволяет запоминать в ячейках памяти не только логические "0" и "1", но и аналоговый сигнал со всеми промежуточными значениями от 0 до 1. Ток считывания из соответствующей ячейки будет почти пропорционален аналоговому сигналу. Это позволяет значительно сэкономить объем памяти во многих видео- и аудио- устройствах (видеокамерах, цифровых фотоаппаратах, диктофонах и т.п.), где требуется сохранять аналоговый сигнал.
Металлический кантилевер переключается электростатическими силами, практически без рассеяния тепла. Поэтому энергопотребление здесь намного меньше, чем в обычной флеш-памяти.
УНТ флеш-память с зарядовыми ловушками
При исследованиях транзисторов с использованием тонких нанотрубок
( нм) и подзатворного диэлектрика
нм) и подзатворного диэлектрика  с высокой диэлектрической постоянной, структура которых показана на
рис.
6.12, неожиданно был выявлен гистерезис на зависимости тока сквозь транзистор от напряжения на затворе.
с высокой диэлектрической постоянной, структура которых показана на
рис.
6.12, неожиданно был выявлен гистерезис на зависимости тока сквозь транзистор от напряжения на затворе.
После отжига таких транзисторов на воздухе при температуре 335 К гистерезис этот становился более заметным, а через 9 часов отжига стабилизировался. Результат показан на
рис.
6.13. При напряжении на затворе  транзистор может находиться в закрытом (точка A на характеристике,
транзистор может находиться в закрытом (точка A на характеристике,  = 0,08 нА) или в открытом состоянии (точка B на характеристике,
= 0,08 нА) или в открытом состоянии (точка B на характеристике,  = 20 нА), – в зависимости от предыстории. Если транзистор находится в состоянии A, и напряжение на его затворе увеличить выше порогового значения (в данном случае приблизительно 2 В), а потом начать снижать, то ток возрастает в соответствии с веткой БВ на характеристике.
= 20 нА), – в зависимости от предыстории. Если транзистор находится в состоянии A, и напряжение на его затворе увеличить выше порогового значения (в данном случае приблизительно 2 В), а потом начать снижать, то ток возрастает в соответствии с веткой БВ на характеристике.
При напряжении на затворе  транзистор теперь находится в открытом состоянии (точка B). Если и дальше снижать напряжение на затворе, то ток изменяется соответственно ветви ВГ. Если отрицательное напряжение на затворе превзойдет другое пороговое значение (в данном случае приблизительно –3 В), то при последующем увеличении этого напряжения ток уменьшается уже соответственно ветви ГА. И теперь при напряжении на затворе
транзистор теперь находится в открытом состоянии (точка B). Если и дальше снижать напряжение на затворе, то ток изменяется соответственно ветви ВГ. Если отрицательное напряжение на затворе превзойдет другое пороговое значение (в данном случае приблизительно –3 В), то при последующем увеличении этого напряжения ток уменьшается уже соответственно ветви ГА. И теперь при напряжении на затворе  транзистор находится уже снова в закрытом состоянии.
транзистор находится уже снова в закрытом состоянии.
Можно условиться, что в случае A в транзистор записан логический "0", а в случае В – логическая "1". Процесс считывания очень прост: надо приложить небольшое напряжение между истоком и стоком и измерить протекающий ток. Для перевода транзистора в состояние логической "1" надо подать положительный импульс напряжения амплитудой свыше 2 В, а для перевода в состояние логического "0" надо подать импульс отрицательного напряжения амплитудой выше 3 В.
Такого же стойкого эффекта памяти, как при отжиге на воздухе, удается достичь и значительно быстрее, обрабатывая транзисторы в плазме кислорода в течение приблизительно 15 с. В обоих случаях (при отжиге на воздухе и при обработке в кислородной плазме) в тонком слое  формируются глубокие ловушки для электронов с энергией активации 0,4-0,6 эВ.
формируются глубокие ловушки для электронов с энергией активации 0,4-0,6 эВ.
Эффект памяти основан на том, что диаметр УНТ очень мал ( 1 нм), и поэтому при напряжении на затворе уже в несколько вольт, вокруг нанотрубки возникает электрическое поле напряженностью порядка 1 В/нм = 109 В/м. При такой напряженности электроны относительно легко преодолевают тонкий (порядка нескольких нанометров) потенциальный барьер и туннельным путем переходят из УНТ в указанные глубокие ловушки или в обратном направлении – из них на УНТ. Когда же такое сильное электрическое поле отсутствует, то электроны могут находиться в ловушках весьма продолжительное время, выполняя в транзисторе роль заряженного "плавающего" затвора. Такой же эффект памяти был со временем выявлен и при использовании в качестве диэлектрика
1 нм), и поэтому при напряжении на затворе уже в несколько вольт, вокруг нанотрубки возникает электрическое поле напряженностью порядка 1 В/нм = 109 В/м. При такой напряженности электроны относительно легко преодолевают тонкий (порядка нескольких нанометров) потенциальный барьер и туннельным путем переходят из УНТ в указанные глубокие ловушки или в обратном направлении – из них на УНТ. Когда же такое сильное электрическое поле отсутствует, то электроны могут находиться в ловушках весьма продолжительное время, выполняя в транзисторе роль заряженного "плавающего" затвора. Такой же эффект памяти был со временем выявлен и при использовании в качестве диэлектрика  и некоторых других окислов.
и некоторых других окислов.
Один описанный транзистор с тремя выводами (исток, сток и затвор) и является элементом новой флеш-памяти на УНТ. Благодаря незначительным нанометровым размерам УНТ, потенциальная плотность такой памяти оценивается величиной свыше 100 Гбит/см2. Возможная частота считывания – порядка 100 ГГц, приблизительно такова же частота записи/перезаписи. Рассеиваемая мощность при считывании информации составляет порядка 20 нА*0,5 В = 10 нВт, во время перезаписи – порядка 1 мкВт. Записанная информация сохраняется при отключенном питании на протяжении многих десятков суток. Такая память является очень перспективной.
УНТ память на элементах с изменением фазового состояния
УНТ позволяют значительно улучшить характеристики еще одного вида энергонезависимой памяти – т.н. "памяти на фазовых переходах" (англ. Phase-change memory, PCM, PRAM, PCRAM, Chalcogenide RAM или C-RAM). Как мы уже рассказывали в лекции 6 курса "Наноэлектронная элементная база информатики на основе полупроводников и ферромагнетиков"., запись, перезапись и хранение информации в такой памяти основаны на способности халькогенидного стекла обратимо изменять под действием импульсов электрического тока свое фазовое состояние из аморфного на кристаллическое и наоборот много раз. При изменении фазового состояния резко меняется и электрическое сопротивление ячейки памяти. Это и позволяет довольно просто считывать текущее состояние ячейки. Затраты энергии на перезапись и ее скорость напрямую зависят в такой памяти от объема стекла, в котором происходит фазовый переход. И этот объем удается значительно уменьшить, применив для подведения электрического тока УНТ малых диаметров. На рис. 6.14 показана конструкция ячеек такой памяти на УНТ с металлической проводимостью. Островки халькогенидного стекла, размещенные в разрывах УНТ, имеют размер порядка 10 нм. Для их переключения из аморфного состояния в кристаллическое требуется импульс тока порядка 0,5 мкА при напряжении меньше 1 В. Энергия переключения составляет порядка 1 фДж = 10-15 Дж.
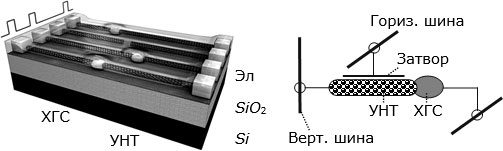
Рис. 6.14. Слева – структура ячеек (4 шт.) фазовой памяти на УНТ с металлической проводимостью. Справа – схема ячейки фазовой памяти на транзисторе из полупроводниковой УНТ
В другом варианте используются полевые транзисторы с полупроводниковыми УНТ. Схема соответствующей ячейки фазовой памяти показана на рис. 6.14 справа. Такой вариант удобней для организации матричной памяти большого объема с произвольным доступом.
По таким же схемам может быть реализована и т.н. "мемристорная" память с УНТ. Термин "мемристор" является производным от английского "memory resistor" (резистор с памятью). В нем используется способность диоксида титана изменять свое электрическое сопротивление на несколько порядков под действием электрического напряжения выше некоторого порога. В случае УНТ благодаря их малому диаметру и соответственно малым объемам мемристоров также достигается значительный рост плотности памяти и скорости считывания, значительное уменьшение энергопотребления.


